SpectraShape optical critical dimension measurement system. Shay Wolfling, Ph Chief Technology Officer. Metro4and EEM450PR Collaborations.
KLA-Tencor Corporation and Tokyo Electron Limited (TEL) have announced AcuShape TM , a new modeling and library-generation package to meet optical critical dimension metrology requirements for the 32nm node and below. NanoCD offers industry- proven modeling methods, as well as next-generation real-time regression capability, .
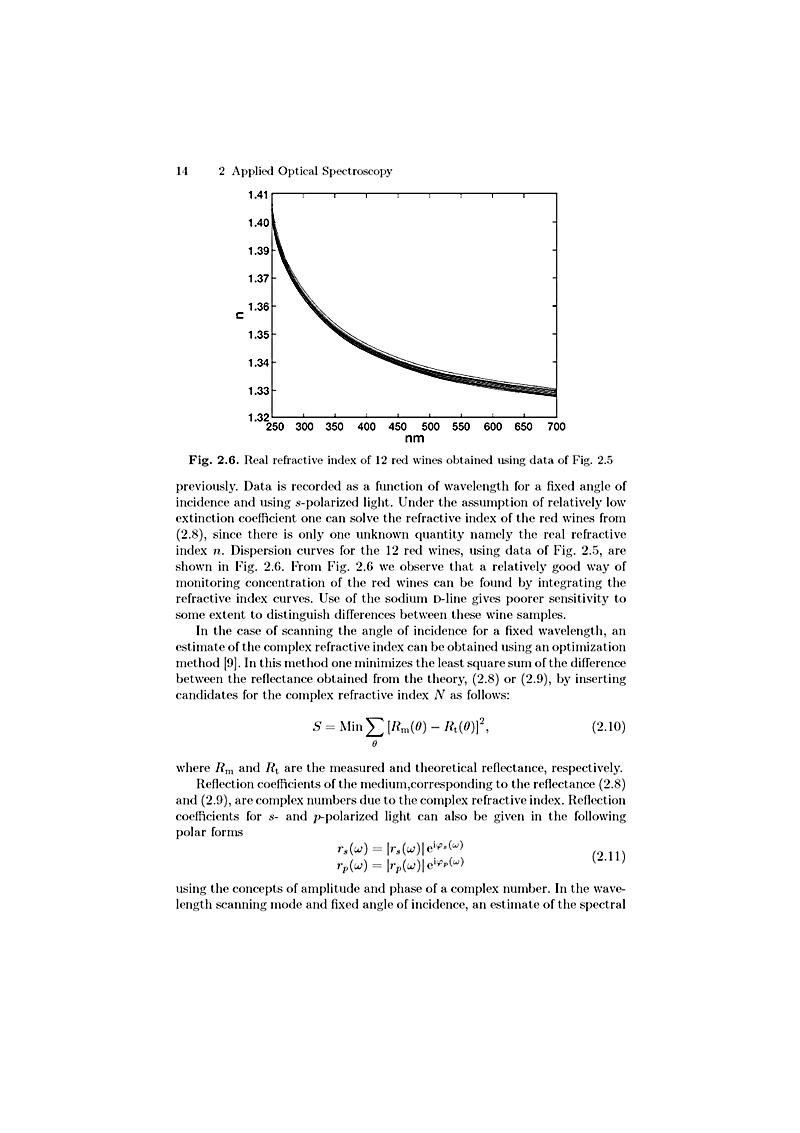
This paper presents three optical wafer metrology sensors that are used in lithography for robustly measuring the shape and position of wafers and device patterns on these wafers.

Actual evaluation of scatterometry for CD measurement.
Optical scatterometry metrology. Surface Topography: Metrology and Properties. View the article online for updates and . The logic manufacturing process requires small in-device metrology targets to exploit the full dose correction potential of the modern scanners and process tools. Key parameters of interest are guide CD , polymer CD , and residual polymer thickness at the bottom of the guide cavity. Most common in semiconductor manufacture are scatterometry, an optical diffraction-based metho and scanning electron microscopy ( CD -SEM), a secondary electron emission-based technology.
Although both are eminently repeatable, fast, and useful in terms of cost per measurement, will they remain . Monitoring of performance critical CDs , such as gate etch, although time- consuming and requiring extensive sampling, is absolutely essential for successful pattern transfer. New productivity-enhancing capabilities reduce tool setup time by percent and enable automate highly precise metrology on advanced process materials. The TSOM method shows the ability to detect . A second technique examined in this paper is hybrid metrology where inputs from source tools such as CD -SEM and CD -AFM are used to determine values of critical parameters. The first examples shows LER sensitivity gains by measuring narrow resist lines in an orientation parallel with the long axis of . CDSEM ( Critical Dimension Scanning Electron Microscopy) measurements are currently used in research and development of DSA patterning technique, but scatterometry-based techniques are preferred for high volume manufacturing.
Abstract: In modern IC industry, optical critical dimension (OCD) technique has been more and more applie as one of the most import process control tools. Scatterometry or optical critical dimension (OCD) metrology tools . It is used for both memory and logic. The knock on OCD is that chipmakers must develop complex and time-consuming models. One way to obtain reference data is to cut .
No comments:
Post a Comment
Note: only a member of this blog may post a comment.